中国苏州纳米技术与纳米仿生研究所(SINANO)已在硅上使用n型脊形波导(nRW)制造了氮化铟镓(InGaN)发射紫光的激光二极管(LDs),这证明了更低的电阻和更高的散热性pRW-LD的性能等。通常,工艺限制表明基于InGaN的激光二极管中的RW位于器件的p侧。由于p-GaN的电阻比n-GaN的电阻大得多,因此出现了热和电问题。
该团队还包括来自中国清华大学的研究人员,他们认为nRW-LD器件可以与大规模的硅基互补金属氧化物半导体(CMOS)主流电子产品完全兼容,并且可以用于单片集成硅中。光子学是一种高效的片上光源,用于高速数据通信和计算。
镁(Mg)是III型氮化物结构中常见的p型掺杂剂。这在产生p型导电性所需的生长和激活退火方面施加了许多限制。首先,镁倾向于在反应室中徘徊。这种“记忆效应”意味着随后的层将具有一定程度的镁掺入,无论是否需要。因此,记忆效应倾向于导致在最后生长p型层的情况下设计生长过程。
而且,掺有Mg的GaN / InGaN被掺入氢钝化(使其无效)。p型层活化的关键部分在于驱散该氢,通常是通过在退火过程中升高温度,以促进这些原子从结构中扩散出来。这就要求氢在离开材料之前要走的距离尽可能短。
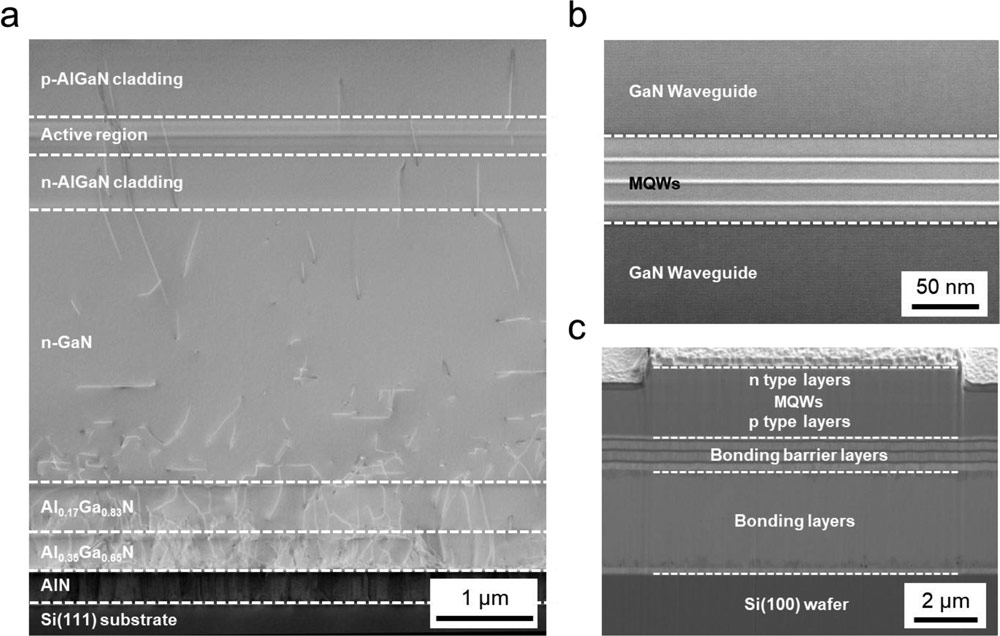
图1:nRW-LD结构的横截面图。(a)在Si(111)衬底上的nRW-LD外延结构的扫描透射电子显微照片。(b)InGaN / GaN量子阱的放大图像。(c)结合到Si(100)晶片上的器件的截面扫描电子显微照片。
RW-LD的III-氮化物异质结构在具有(111)晶体取向的硅上生长。采取措施控制穿线错位密度。激光二极管结构由夹在波导层之间的五个InGaN量子阱组成(图1)。不掺杂n侧波导和最近的包层50nm,避免电流在脊形波导结构中扩散。
将激光二极管结构的p面朝下键合到具有p型欧姆接触电极表面的精确Si(100)晶片上。通过湿蚀刻去除Si(111)生长衬底。进一步的干法等离子体蚀刻去除了AlN / AlGaN生长缓冲结构。倒置的RW-LD结构使包层的n型侧面比通常的要薄得多,约0.5μm。在非倒置结构中,n覆层位于厚GaN模板的顶部,具有“反导”效果。倒置RW-LD覆层的p侧较厚,为1.2μm。
研究人员评论说:“降低具有低导热率的n型AlGaN覆层的厚度可以大大降低由于AlGaN和GaN模板之间的晶格失配而导致的热阻和拉伸应力,从而提高了器件性能和制造效率让。”
最终将键合材料制成10μmx800μmRW-LD器件(图2)。p电极的有效面积估计为300μmx800μm。

图2:基于InGaN的(a)Si(111)上的pRW-LD和(b)Si(100)上的nRW-LD的示意图结构。
反向漏电流为〜10-7A以-5V反向偏压。开启电压约为3.0V。与Si(111)上的正常pRW-LD相比,偏置电压的增加会给反向RW-LD注入更高的电流。这反映了在较宽的p型区域上较低的串联电阻。
反向nRW-LD注入350mA时的差分电阻为1.2Ω,而普通pRW器件为2.3Ω。这将工作电压从1.41V降低到4.15V。较低的电压意味着减少了焦耳热,从而延迟了激光性能的热降解。反向器件的热阻估计为18.2K / W,而普通的p脊激光二极管的反向电阻为26.5K / W。在350mA下连续波(CW)操作下的结温分别为48.5°C和73.5°C。结温低25°C归因于焦耳热降低和散热路径长度缩短。
由于研究人员在晶圆键合工艺中使用了镍锡焊料,导热率相对较低,因此还有改进的余地。铜基替代品可能是实现更高热性能的一种方法。
在100mA注入时,nRW-LD结构的半峰全宽(FWHM)光谱线为12nm(图3)。在320mA时,线宽缩小到0.8nm,在阈值处给出的激光模式波长为418.3nm。
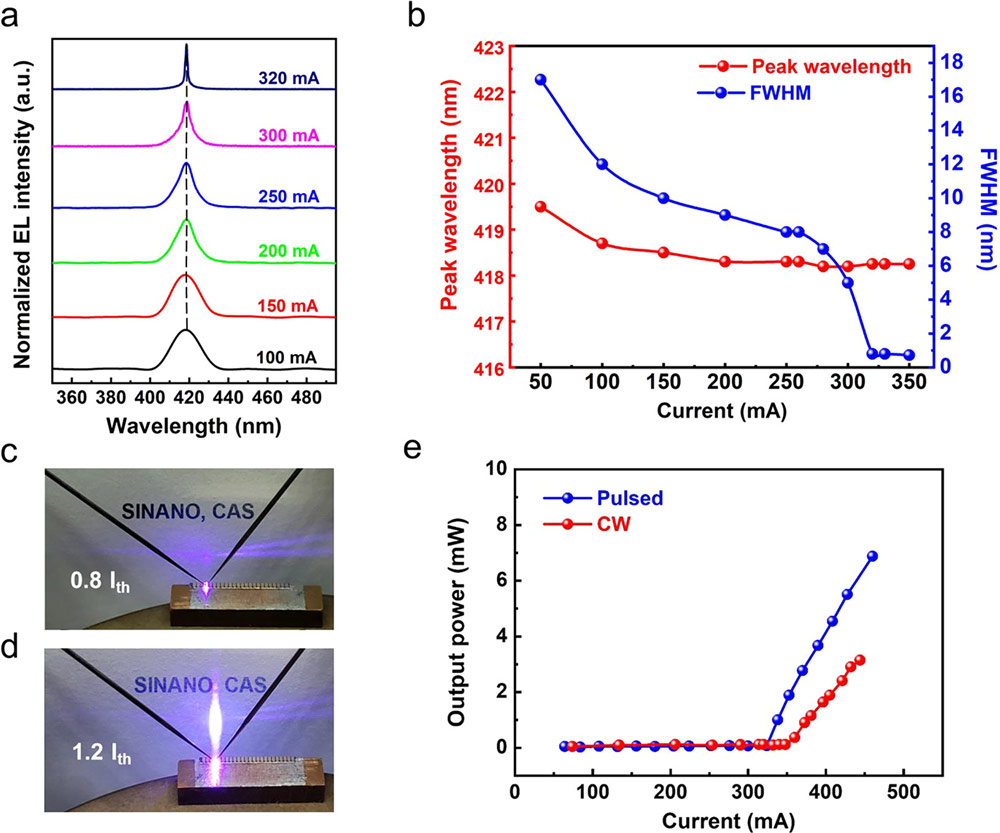
图3:电注入下nRW-LD的电致发光。(a)在室温(RT)的脉冲电流(占空比为0.4%,重复频率为10kHz)下的光谱。(b)光谱的峰值波长和半峰宽与RT下的脉冲注入电流的关系。(c,d)远场模式观察到0.8x和1.2x阈值电流。(e)在室温下,光输出功率与脉冲和CW注入电流的关系。
相对于在CW操作下的最新InGaN激光二极管,4.37kA / cm2的阈值电流密度被认为是很高的。在观察到“输出功率急剧下降”之前,寿命也只有5分钟。研究人员归咎于高6x108/ cm2螺纹位错密度和未优化的有源区。螺纹位错提供了非辐射复合中心和泄漏电流路径,从而降低了效率和可靠性。一些研究表明,通过将螺纹位错减少到106/ cm 2,可以将激光二极管的寿命增加到10,000小时。


